半導体や電子機器の信頼性評価をサポート
エスペック株式会社は、半導体パッケージや電子実装基板の信頼性向上、評価期間短縮に貢献する「熱変形・熱画像データを用いた基板反りCAE解析結果の妥当性確認サービス」を開始します。
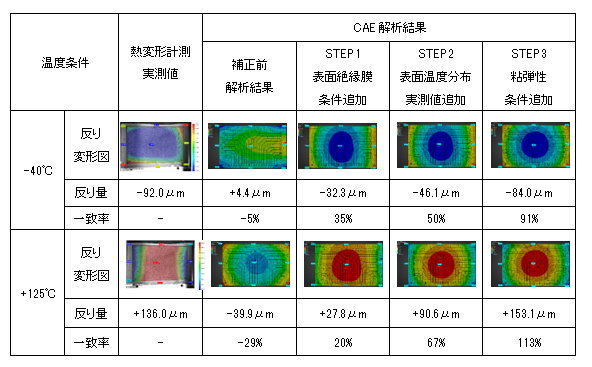
近年、開発・設計段階でCAE技術を活用した信頼性解析が進んでいます。特に、AI、EV、データセンターに用いられる半導体パッケージや電子実装基板は微細配線が多く、温度変化による故障リスクが高まっています。
そのため、サンプルの熱膨張・収縮による反りをシミュレーションし、設計妥当性を検証するCAE解析が有効とされています。しかし、解析結果の品質を担保するためには、その妥当性を確認することが重要です。
CAE解析精度の向上に向けた取り組み
今回のサービスは、CAEソリューションを提供するサイバネットシステム株式会社との連携によって実現しました。エスペックが開発した計測システムで得られる熱変形・熱画像データ(変位・ひずみ、試料表面の温度分布)を用いてCAE解析条件を検証します。
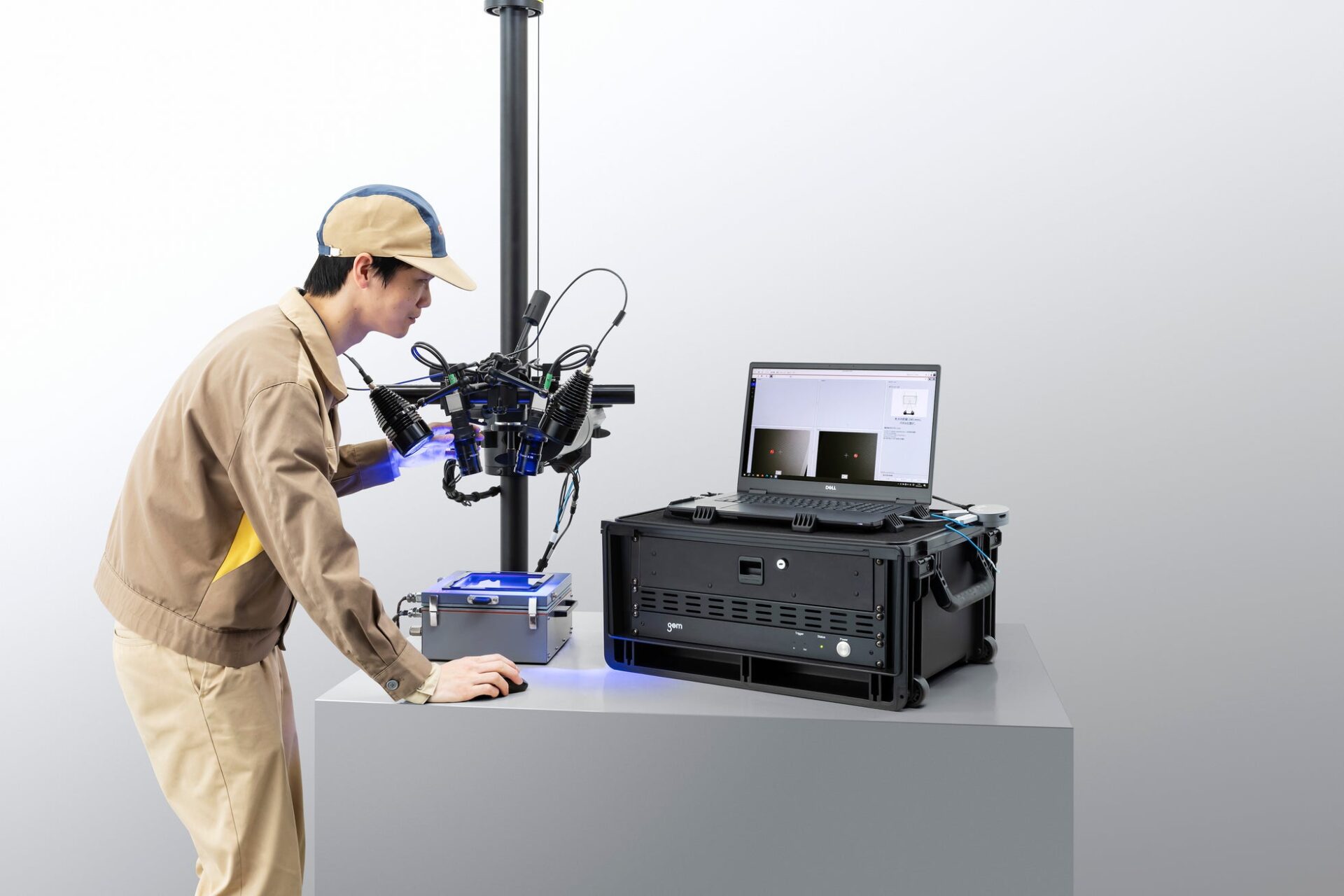
これにより、基板反り解析精度を向上させ、半導体パッケージや電子実装基板の実装信頼性評価、熱設計・熱対策を強力にサポートします。
CAE解析の誤差要因は完全になくすことが難しいため、実測データとの比較検証によって解析結果の信頼性を高めることが重要です。
サービス用途例
基板反りCAE解析結果の妥当性確認サービスの用途例
- 2D、3D半導体パッケージ用サブストレートやインターポーザーの熱反り変形解析
- 半導体や電子実装基板のはんだ接合部の亀裂進展解析
- 基板用エポキシ材、アンダーフィル材、ソルダーレジスト材などの樹脂系材料の挙動解析
サービスでは、実測データとCAE解析の結果を比較し、誤差の検証を行います。これにより、より信頼性の高い設計が可能になります。
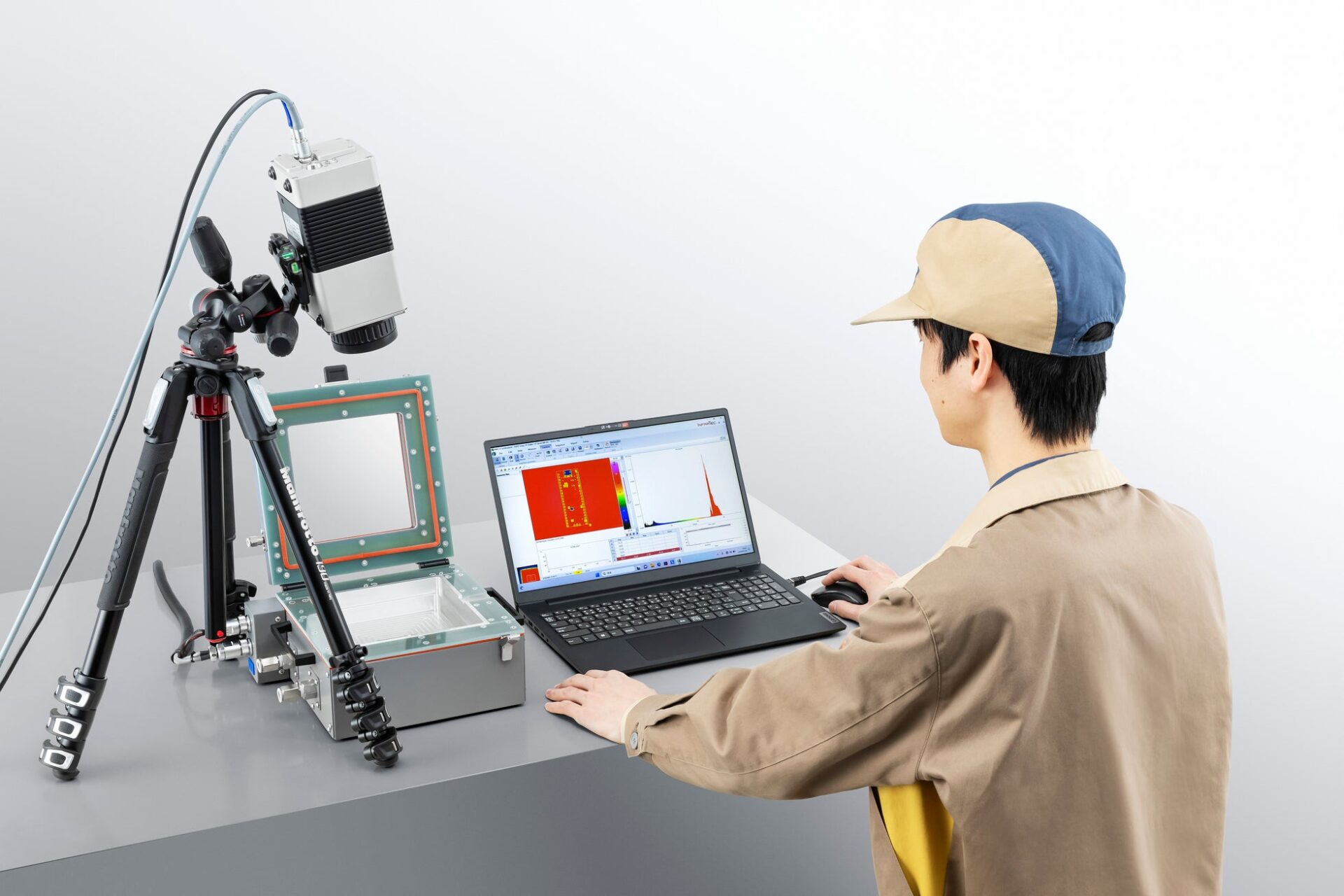
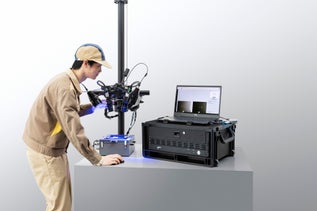
熱変形計測システムと熱画像解析システムについて
このサービスでは、3次元デジタル画像相関法(3D DIC)とエスペックの計測専用恒温槽を組み合わせたシステムを使用します。これにより、-40~+260℃の恒温環境下で、半導体パッケージや実装基板、車載部品などの熱変形を可視化します。
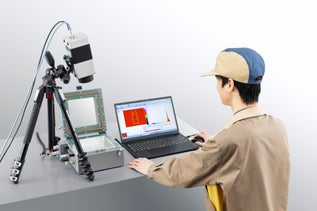
また、サーモグラフィで取得した熱画像解析データを取り込み、変位・ひずみ分布と温度分布を比較検証することが可能です。
この融合によって、より詳細かつ正確な熱変形解析が可能になります。
 Ms.ガジェット
Ms.ガジェット
最後までお読みいただきありがとうございました!
- 本記事の評価は当サイト独自のものです。
- 特段の表示が無い限り、商品の価格や情報などは記事執筆時点での情報です。
- この情報が誤っていても当サイトでは一切の責任を負いかねますのでご了承ください。
- 当サイトに記載された商品・サービス名は各社の商標です。
- 本記事で使用している画像は、メディアユーザーとしてPR TIMESより提供されたプレスリリース素材を利用しています。